
MF138900 - SEMI MF1389 - Test Method for Photoluminescence Analysis of
Electronic-grade polycrystalline silicon producers and users require information regarding impurities for quality assurance as well as for research and development purposes. Polysilicon is float-zoned and a sample from the zoned rod is analyzed following this Test Method to obtain impurity densities that can be related to the impurity content of the starting material. Photoluminescence analysis identifies and quantifies the electrically active dopant impurities in monocrystalline silicon. This Test Method addresses boron, phosphorus, arsenic, and aluminum, found as impurities in electronic grade silicon. This Test Method can be applied to doped and undoped float-zoned or Czochralski material. This Test Method covers the simultaneous determination of electrically active boron, phosphorus, arsenic, and aluminum content in low-dislocation monocrystalline silicon. This Test Method can be used for samples that have dopant densities between approximately 1 × 1011 and approximately 5 ×
Electronic-grade polycrystalline silicon producers and
users require information regarding impurities for quality assurance as well as
for research and development purposes. Polysilicon is float-zoned and a sample
from the zoned rod is analyzed following this Test Method to obtain impurity
densities that can be related to the impurity content of the starting material.
Photoluminescence analysis identifies and quantifies the
electrically active dopant impurities in monocrystalline silicon. This Test Method
addresses boron, phosphorus, arsenic, and aluminum, found as impurities in
electronic grade silicon.
This Test Method can be applied to doped and undoped
float-zoned or Czochralski material.
This Test Method covers the simultaneous determination of
electrically active boron, phosphorus, arsenic, and aluminum content in
low-dislocation monocrystalline silicon.
This Test Method can be used for samples that have dopant
densities between approximately 1 × 1011 and approximately 5 × 1015 atoms/cm3.
The concentrations obtained using this Test Method is based
on an empirically determined relationship of the logarithm of the concentration
to the logarithm of specific luminescence line-intensity ratios.
The empirical relationship established assumes a constant
sample excitation level for all measurements on a given instrument.
To accommodate differences in instrumentation, two methods
are included. Test Method A refers to procedures appropriate for dispersive
infrared spectrophotometers operating under the high sample excitation
conditions and Test Method B refers to procedures appropriate for Fourier
transform instruments operating under low excitation conditions.
Typical calibration curves for each test method are
provided. These curves are modified for each instrument using the analysis of standard
samples as reference data. Once modified, the curves for a given instrument
should produce sample dopant density values that agree with other similarly
operated instruments using the same test method. Data obtained using Test
Method A may not agree with data obtained using Test Method B, hence values
must be reported with reference to the test method used.
Many laboratories use photoluminescence to analyze
epitaxial layers. However this application encounters many variables and the
underlying physics is not fully understood; hence these test methods do not
attempt to outline standard practices regarding such analysis.
Referenced SEMI Standards (purchase separately)
SEMI C28 — Specification for Hydrofluoric Acid
SEMI C30 — Specification for Hydrogen Peroxide
SEMI C35 — Specification and Guide for Nitric Acid
SEMI M59 — Terminology for Silicon Technology
SEMI MF723 — Practice for Conversion Between Resistivity
and Dopant or Carrier Density for Boron-Doped, Phosphorus-Doped, and
Arsenic-Doped Silicon
SEMI MF1630 — Test Method for Low Temperature FT-IR
Analysis of Single Crystal Silicon for III-V Impurities
SEMI MF1723 — Practice for Evaluation of Polycrystalline
Silicon Rods by Float-Zone Crystal Growth and Spectroscopy
Revision History
SEMI MF1389-1115 (Reapproved 0222)
SEMI MF1389-1115 (technical revision)
SEMI MF1389-1110 (technical revision)
SEMI MF1389-0704 (technical revision)
SEMI MF1389-00 (first SEMI publication)
Electronic-grade polycrystalline silicon producers and
users require information regarding impurities for quality assurance as well as
for research and development purposes. Polysilicon is float-zoned and a sample
from the zoned rod is analyzed following this Test Method to obtain impurity
densities that can be related to the impurity content of the starting material.
Photoluminescence analysis identifies and quantifies the
electrically active dopant impurities in monocrystalline silicon. This Test Method
addresses boron, phosphorus, arsenic, and aluminum, found as impurities in
electronic grade silicon.
This Test Method can be applied to doped and undoped
float-zoned or Czochralski material.
This Test Method covers the simultaneous determination of
electrically active boron, phosphorus, arsenic, and aluminum content in
low-dislocation monocrystalline silicon.
This Test Method can be used for samples that have dopant
densities between approximately 1 × 1011 and approximately 5 × 1015 atoms/cm3.
The concentrations obtained using this Test Method is based
on an empirically determined relationship of the logarithm of the concentration
to the logarithm of specific luminescence line-intensity ratios.
The empirical relationship established assumes a constant
sample excitation level for all measurements on a given instrument.
To accommodate differences in instrumentation, two methods
are included. Test Method A refers to procedures appropriate for dispersive
infrared spectrophotometers operating under the high sample excitation
conditions and Test Method B refers to procedures appropriate for Fourier
transform instruments operating under low excitation conditions.
Typical calibration curves for each test method are
provided. These curves are modified for each instrument using the analysis of standard
samples as reference data. Once modified, the curves for a given instrument
should produce sample dopant density values that agree with other similarly
operated instruments using the same test method. Data obtained using Test
Method A may not agree with data obtained using Test Method B, hence values
must be reported with reference to the test method used.
Many laboratories use photoluminescence to analyze
epitaxial layers. However this application encounters many variables and the
underlying physics is not fully understood; hence these test methods do not
attempt to outline standard practices regarding such analysis.
Referenced SEMI Standards (purchase separately)
SEMI C28 — Specification for Hydrofluoric Acid
SEMI C30 — Specification for Hydrogen Peroxide
SEMI C35 — Specification and Guide for Nitric Acid
SEMI M59 — Terminology for Silicon Technology
SEMI MF723 — Practice for Conversion Between Resistivity
and Dopant or Carrier Density for Boron-Doped, Phosphorus-Doped, and
Arsenic-Doped Silicon
SEMI MF1630 — Test Method for Low Temperature FT-IR
Analysis of Single Crystal Silicon for III-V Impurities
SEMI MF1723 — Practice for Evaluation of Polycrystalline
Silicon Rods by Float-Zone Crystal Growth and Spectroscopy
Revision History
SEMI MF1389-1115 (Reapproved 0222)
SEMI MF1389-1115 (technical revision)
SEMI MF1389-1110 (technical revision)
SEMI MF1389-0704 (technical revision)
SEMI MF1389-00 (first SEMI publication)
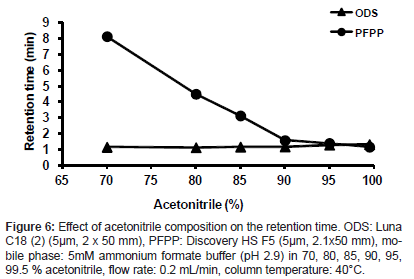
Characteristic Features of an Analytical Column with a

Multi-photon attenuation-compensated light-sheet fluorescence
Fluorescence recovery after photobleaching - Wikipedia

Confocal microscopy as a new real-time quantification method for

PDF) Effect of Silicon Crystal Size on Photoluminescence Appearance in Porous Silicon

Frontiers Flexible Multi-Beam Light-Sheet Fluorescence Microscope for Live Imaging Without Striping Artifacts

Post-synthetic modification of MIL-53(Fe) with Tb3+ and guanosine

Basic Photoluminescence (PL) Measurement Techniques
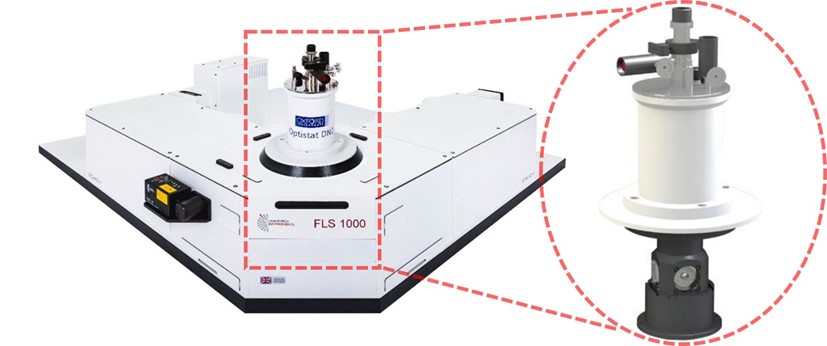
Measuring Fluorescence and Phosphorescence Spectra

OpenFLUX2: 13C-MFA modeling software package adjusted for the comprehensive analysis of single and parallel labeling experiments, Microbial Cell Factories

General description

Advances in fluorescence microscopy techniques to study kidney

Characterizing process semiconductor thin films with a confocal micro X-ray fluorescence microscope, Powder Diffraction

Principle setup of a light sheet fluorescence microscope using a









